SDBG (Stealth Dicing Before Grinding) プロセス
ソリューション
スマートフォンやタブレット端末の薄型化・大容量化にともない、フラッシュメモリやメモリコントローラチップのさらなる薄化が求められている中、従来のプロセスでは、薄ウェーハのハンドリングや、ダイシングにおけるチッピングの低減が課題となっています。
SDBGプロセスは、これらの課題に対応すると共に
- チップ取れ個数増加
- 薄チップの抗折強度向上
を実現します。
SDBGプロセスとは
SDBGは、ステルスダイシング加工後に裏面研削をおこなう技術で、薄チップの狭ストリート化と抗折強度の向上を実現します。
ダイセパレータ(DDSシリーズ)との組み合わせにより、薄チップ積層時にボンディング材として用いられるDAF (Die Attach Film)を高品位に分割します。
プロセスフロー
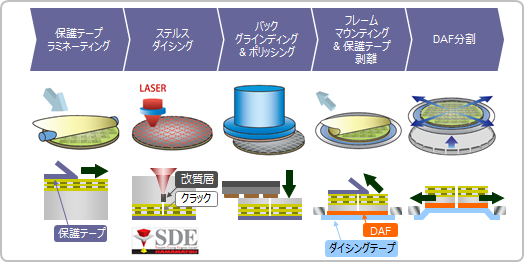
チップ取れ個数UP
ステルスダイシング加工はカーフがほぼゼロであるため、狭ストリート化に大きく貢献します。通常のダイシングと比較して、ウェーハ1枚あたりのチップ取れ個数の増加が期待できます。
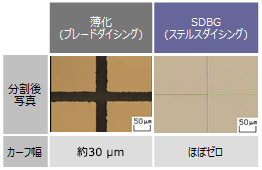
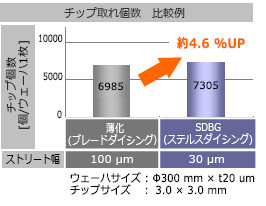
チップの抗折強度向上
ブレードによる分割は、表・裏面チッピング、および、チップ側面に残る加工痕が抗折強度に影響を与えます。 SDBGでは、ステルスダイシング加工によって改質された部分を起点にチップを分割し、改質部分を研削にて除去します。そのため、表・裏面チッピングを低減したうえ、チップ側面の加工痕がない高強度の薄チップを作ることができます。
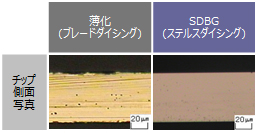
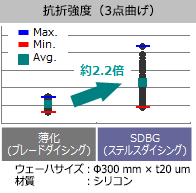
DAF (Die Attach Film)の高品位分割
ダイセパレータ(DDSシリーズ)にて、DAFを低温環境下でエキスパンドすることにより、高品位な分割が可能となります。
エキスパンド後のダイシングテープ部分のたるみは、ヒートシュリンクで解消するため、ダイシングテープの貼り替えなく、次のダイボンディング工程へ搬送することができます。

関連情報
SDBG 対応製品
https://www.disco.co.jp/jp/products/index.html?id=sdbg
お問い合わせ
ご質問・ご相談等ございましたら、お気軽にお問い合わせ下さい。