DBG (Dicing Before Grinding)プロセス
ソリューション
DBGプロセスとは
DBGは従来の「裏面研削 →
ウェーハ切断」というプロセスを逆転させ、先にウェーハをハーフカットした後、裏面研削によりチップ分割する技術で、チップ分割(ダイシング)時の裏面のチッピングとウェーハの破損を最小限に抑えつつ、大口径ウェーハからチップを切り出すことが可能となります。
裏面チッピングが少ないため、高い抗折強度を維持しながら薄仕上げ加工が行え、強度の高いチップを製造することができます。
また、グラインダによる研削でチップ分離を行うため、薄いウェーハを搬送するリスクがなくなるというメリットがあります。
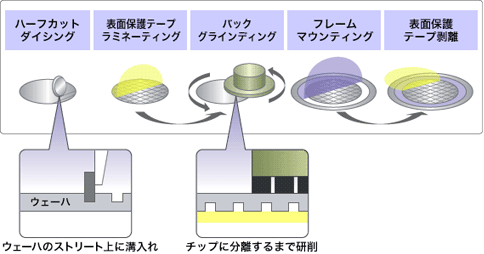
ハーフカットダイサでウェーハ上のストリート(切り代)に溝入れを行います。通常のダイシングでは裏面まで完全に切断しますが、DBGプロセスの場合は目的のチップ厚さまでの溝入れを行います。 ハーフカットダイシング後、ウェーハ表面に保護テープを貼り付け、グラインダで裏面を研削します。研削が進み、先に切り込まれた溝に到達した際、ウェーハは個々のチップに分割されます(チップ分離)。この分割されたウェーハはインラインでDBGマウンタへ搬送し、アライメントを行い、その後フレームにマウントします。フレームマウント後、表面保護テープを剥がして工程は終了します。
関連情報
DBG対応製品詳細
https://www.disco.co.jp/jp/products/index.html?id=dbg
お問い合わせ
ご質問・ご相談等ございましたら、お気軽にお問い合わせ下さい。