去除切割污染物
解決方案
現在,用於手機,數位照相機等領域的CCD/CMOS圖像傳感器對於無切割污染物殘留的品質要求變得越來越嚴格。此外,在各種IC元件領域也發生因切割污染物殘留在接線頭處而導致其接線不良等問題。因此如何去除切割污染物已成為目前迫切需要解決的課題。
為了滿足市場的要求,迪思科公司正在研究開發各種規格的設備和應用技術。
應用技術(水氣雙流體清洗裝置:已取得專利)
水氣雙流體清洗裝置
現在,已證實水氣雙流體清洗裝置具有比高壓清洗更強的清洗能力。
水氣雙流體清洗裝置分為
- 切割中實施清洗作業的切割部水氣雙流體噴射裝置
- 切割後在清洗部實施清洗作業的清洗部水氣雙流體清洗裝置
主要效果:1.去除附著在微晶體上的切割污染物; 2.去除附著在接線頭上的矽屑等切割污染物。
<接線頭部切割污染物附著改善效果的比較>
-
在清洗部實施高壓清洗

-
在清洗部實施水氣雙流體清洗

水氣雙流體清洗機構
水氣雙流體清洗結構的優點
水氣雙流體噴頭是利用壓縮空氣的高速流動會使液體噴霧化的噴頭,該噴頭具有如下的特點。
- 噴霧化後之水滴的尺寸很小
- 能夠形成噴射力很強的噴霧
當水滴直接衝洗到超微顆粒時,利用水滴內部的壓力變化,會使超微顆粒從晶片表面上剝離。若水滴不能直接衝洗到超微顆粒時,便可再利用噴射水流將超微顆粒衝走。
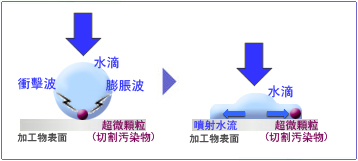
通常,在切割機上普遍採用的方法是利用高壓泵將清洗水加壓到6~10MPa後,再進行高壓清洗作業
水氣雙流體清洗裝置作為選配項目,可置換原來利用高壓清洗作業的部份,並且具有無須更換類似高壓噴頭的噴嘴(tip)等消耗品的優點。該裝置主要安裝在清洗部和切割區部。
安裝於切割部以及清洗部的水氣雙流體清洗裝置已經在日本等主要國家取得了技術專利。(專利號第3410385號)
其他
迪思科公司不僅開發了水氣雙流體清洗裝置,而且還準備了以下的改進方案。
- 切割保護蓋部噴頭形狀的變更
- 切割液的使用
- 切割水流量的最佳化
- 加工方法的最佳化

