ドライポリッシング(ストレスリリーフ)
ソリューション
近年、コンピュータや携帯電話などに搭載されるICパッケージの小型化・高密度化に伴って、パッケージ内のデバイスにも小型化・薄化が求められてきています。デバイスウェーハを薄化することによって、チップ強度が弱まりアセンブリ工程で割れが発生したり、反り量が増大してスタックパッケージのダイボンディングなどが困難になることがあります。これらを改善する手法として、グラインディング工程後にストレスリリーフを導入する方法が考えられています。
ストレスリリーフとしては、主に以下の4手法がありますが、ここではドライポリッシングについてご紹介いたします。
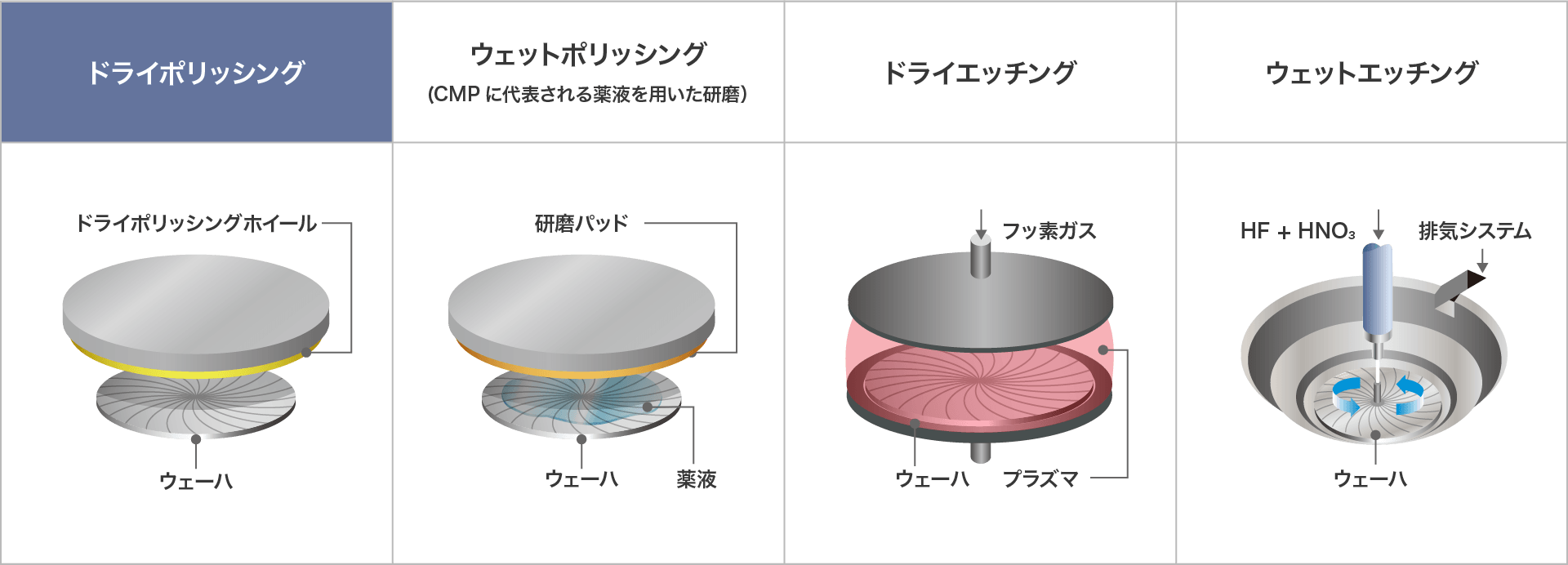
アプリケーション
バックグラインディングプロセスにドライポリッシング工程を追加することにより、グラインディングによる研削ダメージが除去され、更なる抗折強度の向上が可能となります。ドライポリッシング工程により、主に以下の3つの効果が得られます。
- 裏面の鏡面化
- 反り量の低減
- 抗折強度向上
図2.に示すように、グラインディングのダメージ除去の指標となる抗折強度(球抗折)の結果から、2 µm除去を推奨しております。

加工対応装置
お客様の使用環境に合わせることのできる高い拡張性と、幅広いアプリケーションを実現させる機能を備えたラインアップを取り揃えています。
砥石
ディスコ独自の技術によって開発したストレスリリーフ用のドライポリッシングホイールです。
<特徴>
- ノンダイヤモンド砥粒子
ソーマークなく加工が可能 - 固定砥粒砥石
スラリーなどを使用しない = 環境負荷が小さい、ホイールのみで加工が可能 - ドライ加工
加工に水やスラリーを使用せず、CoOの低減が可能
お問い合わせ
ご質問・ご相談等ございましたら、お気軽にお問い合わせ下さい。