SiCなど高硬質素材向け、チップ分割装置を開発
半導体製造装置メーカー・株式会社ディスコ(本社:東京都大田区、社長:関家 一馬)は、SiCやサファイアなどの高硬質素材に向けた、Φ200mmテープフレーム対応フルオートダイセパレータDDS2020を開発しました。
本装置はSEMICON Japan 2023(12/13-15 東京ビッグサイト)に出展する予定です。

開発背景
ステルスダイシングTMは、レーザを加工対象の内部に集光することで照射箇所に改質層を形成し、外部応力を加えてチップ分割をおこなうダイシングプロセスです。シリコンウェーハの場合は比較的小さな応力で分割可能なため、ダイシングテープをエキスパンドすることで、割断を行います。一方、パワーデバイスの素材として普及が進むSiCウェーハや、LEDに使われるサファイアウェーハは機械的強度が高く、エキスパンドだけでは分割できないことがあり、ブレーキング機構が必要でした。
DDS2020は新ブレーキング機構を採用し、SiCやサファイアなど機械的強度が高い材料に対し、低荷重での分割を可能としたダイセパレータです。
特徴
- 低荷重での分割を可能とした新ブレーキング機構を搭載
- 一般的なブレーキング機構に比べ、荷重を4割軽減
- ブレーキング荷重を計測、グラフ表示
- 未分割チップを検出でき、歩留まりが向上
- 未分割時の自動リトライ設定も可能

- ブレーキングのためのテープフレームの貼り替え※不要
- 貼り替え工数、テープコストを削減
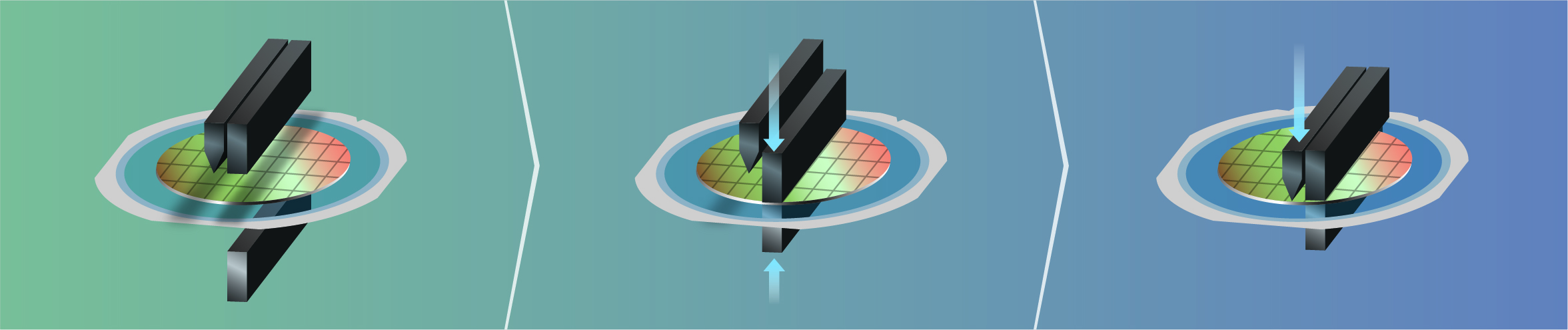
※Φ200mm ウェーハをブレーキングする際、従来必要だったΦ300mm テープフレームへの貼り替えが不要
今後の対応
| SEMICON Japan 2023出展 | 2023年12月13日~15日 東京ビッグサイト |
|---|---|
| テストカット | 受付中 |
| 販売開始予定 | 受注可 |
株式会社ディスコについて
当社は、半導体や電子部品の製造に使用されるダイシングソーやグラインダなどの精密加工装置、および装置に取り付けて使用する精密加工ツールを提供する「半導体製造装置メーカー」です。これら製品に加え、装置とツールの利用技術の提供によりお客様の最適な加工結果を追求してきた結果、国内外のデバイスメーカーおよび半導体受託製造企業などに広く、当社製品・加工技術が採用されています。
詳細については、ウェブサイトwww.disco.co.jpをご覧ください。
お問い合わせ
株式会社ディスコ 広報室
