等离子切割加工
解决方案
等离子切割是在真空下进行干式刻蚀,使晶圆芯片化(单片化)的加工技术。在等离子切割中使用的Bosch process※(参照图)可实现高速、高纵横比、窄切割道的芯片化。
在分立式元器件和RFID等加工领域,为了增加单位晶圆上可获取的芯片个数,正逐步向窄切割道方向发展。此外,面向移动设备和物联网需求旺盛的小芯片元器件对产能的要求日趋严格。同时,等离子切割也可对应车载半导体等要求零缺陷的高品质加工的元器件。
※德国Robert Bosch GmbH在1992年发明的方法
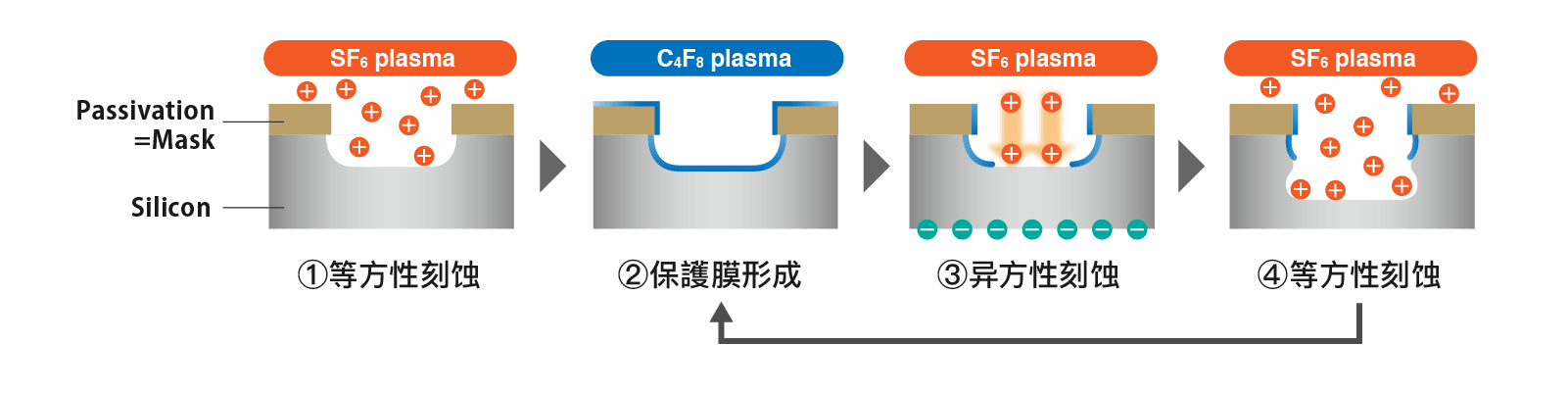
等离子切割的优点
提高小芯片元器件的生产率
由于晶圆上的切割道可同时加工,所以即使是小芯片元器件也能维持高UPH。同时,窄切割道化对应也可增加单位晶圆的芯片获取个数。-
可对应各式加工形状
干式刻蚀法加工可按照掩膜图案的形状进行芯片化。
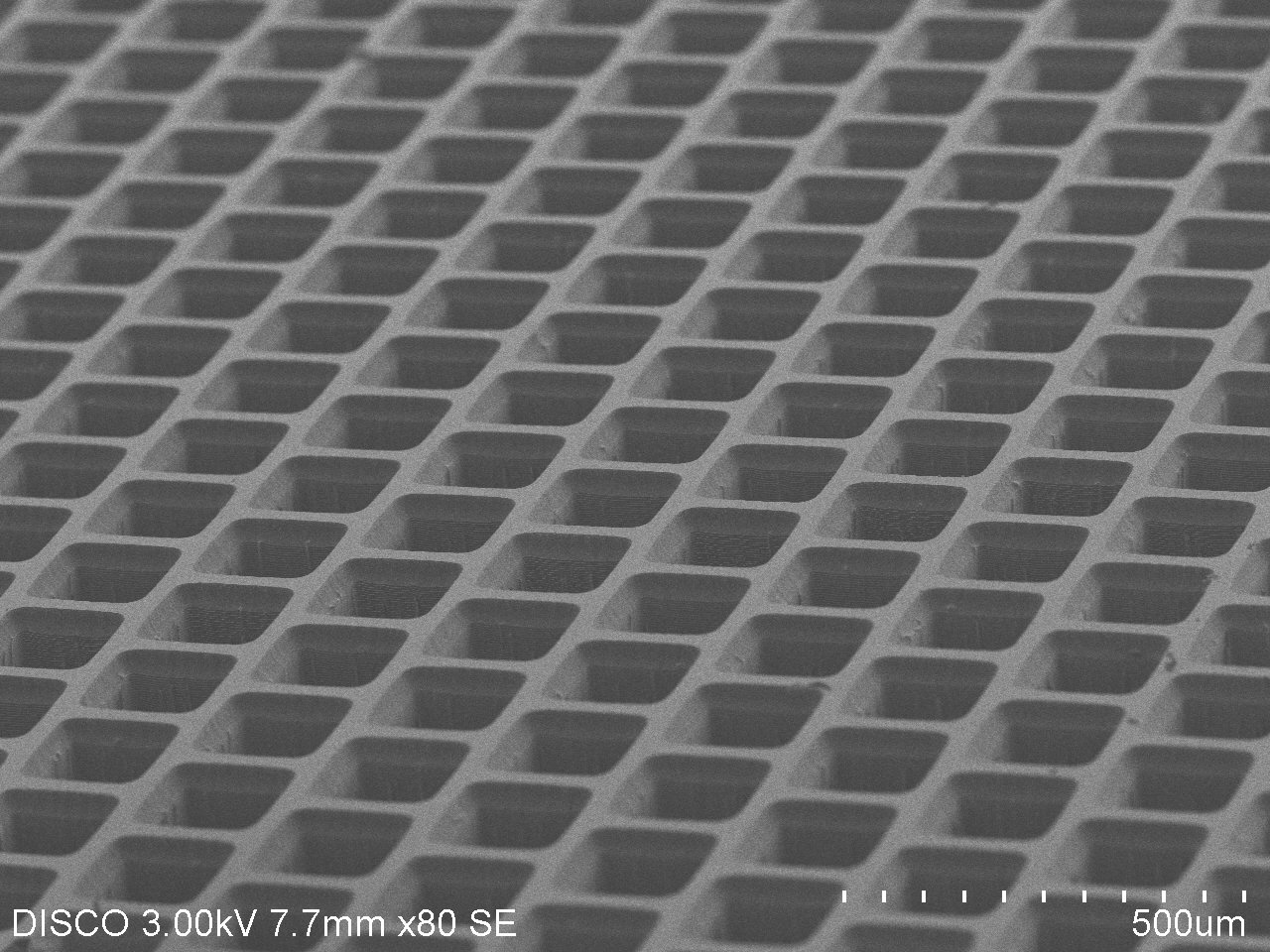

高洁净流程
等离子切割并非机械加工,而是利用化学反应的干式刻蚀制程,因此不会产生加工屑和溶解残渣等。芯片强度提升
通过使用无机械损伤、热影响小的等离子切割,可以提高芯片强度。
工艺
迪思科可提供的整体解决方案
在一般的器件中,切割道上存在着阻碍等离子切割的膜和金属等,因此,在进行等离子切割前需要先行将其去除。因此,本公司依靠多年加工技术和工艺的技术积累 ,可为客户提供器件成形后的硅晶圆芯片化的一站式加工服务。
应用例:
切割道上有金属的硅晶圆的芯片化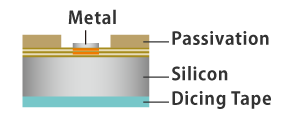
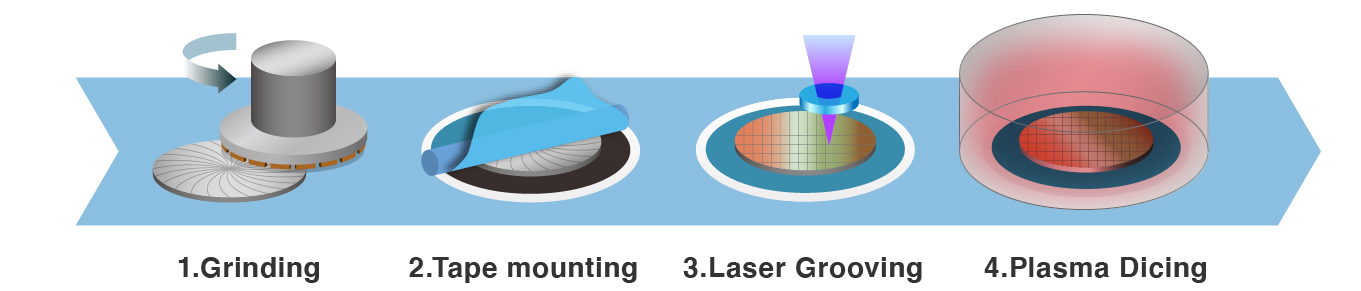
- 背面研磨:通过磨片机/抛光机使晶圆薄型化
- 贴膜机:用贴膜机将难以手动搬送的薄晶圆粘贴至框架上
- Laser Grooving:用激光切割机去除切割道部分的钝化膜和TEG等金属部分
- 等离子切割:晶圆在框架上实现等离子切割
工艺应用实绩
- Power device
- LED
- RFID
- RF filter
- MEMS
- TVS(Zener diode) 等
与美国Plasme-Therm公司的商务合作

本公司与美国Plasme-Therm公司于2016年4月签订商务合作合同,向全球提供该公司的等离子切割装置所用的R&D、试切割、设备销售及售后支持等服务。

