고주파 디바이스에 사용되는 GaAs(갈륨 비소)등의 화합물 반도체는 종래의 다이아몬드 블레이드를 사용한 다이싱(이하: 블레이드 다이싱)에서는 절삭속도가 느려, 높은 생산성을 기대하기가
어려웠습니다
또한, SiP(System in Package)등에 의한 고집적화를 배경으로 항절강도가 높은 박형 칩(Thin Die)의 제조기술 중요성이 나날이 높아지고 있습니다. 그러나 블레이드 다이싱에서는 웨이퍼
두께가 따라 다이싱의 난이도 또한 어렵습니다.
DISCO에서는 이러한 문제를 해결하기 위해 레이저쏘 DFL7161 레이저 헤드와 광학계의 최적화로
레이저에 의한
풀 커팅 어플리케이션을 확립하였습니다.
어플리케이션
레이저 풀 커팅 다이싱 프로세스
두께 200 µm이하의 박형 웨이퍼(Thin Wafer) 상면(패턴면)에 레이저를 1회 또는 여러 차례 조사, 테이프까지 커팅하여 웨이퍼를 풀 커팅하는 방법입니다. 레이저 풀 커팅 다이싱은 절삭속도를 상승시킬 수 있어, 처리율이 향상합니다.

가공 실례
GaAs화합물 반도체의 박형 웨이퍼(Thin Wafer) 다이싱
GaAs웨이퍼는 매우 약한 소재이기 때문에, 다이싱중인 웨이퍼의 깨짐이나 균열이 발생하기 쉬워 종래의 블레이드 다이싱에서는 절삭속도의 상승이 어려웠습니다. 레이저 풀 커팅에서는 블레이드 다이싱의 약 10배 이상의 절삭속도로 가공할 수 있어, 이율이 향상합니다.(절삭속도는 일례입니다. 실제 가공할 웨이퍼에 따라 상이함)
레이저 풀 커팅 다이싱은 가공 후의 커프(Kerf)폭이 작아 블레이드와 비교해서 커프 손실이 적으므로 스트리트폭 저감(Street reduction)을 실현할 수 있습니다. 작은 칩으로 절단하기 위해 가공라인 수가 많아지는 경우가 많은 화합물 반도체 웨이퍼는, 스트리트 저감를 실현하여 웨이퍼 1장에서 생산할 수 있는 칩 개수를 늘릴 수 있습니다.
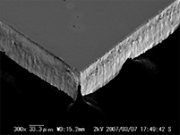
※GaAs 가공시에는 부대설비로서 기화한 As가스를 제거하는 설비가 필요합니다.
박화(Thinning) 한 실리콘 웨이퍼의 풀 커팅 다이싱
웨이퍼의 박화(Thinning)에 따라 다이싱을 할 때의 칩핑이나 균열이 칩의 강도에 끼치는 영향도 커집니다. 그렇기 때문에, 칩핑을 보다 억제한 가공이 요구되며, 다이싱의 난이도는 높아집니다. 또한 박형 칩(Thin Die)을 적층하는 본딩재로 DAF(Die Attach Film)의 사용량이 늘어남에 따라, 이면에 DAF를 점착한 웨이퍼에서 버(Burr) 등의 발생을 억제하여 고품질로 다이싱하는 것도 과제가 되고 있습니다.
이러한 과제에 대해 DISCO에서는 실리콘 박형 웨이퍼의 다이싱 솔루션 중의 하나로써 레이저로 풀 커팅 다이싱하는 어플리케이션을 확립하고 있습니다. 레이저 풀 커팅 다이싱은 레이저의 고속가공에 의한 UPH향상을 기대할 수 있습니다. 또한 DAF점착 실리콘 웨이퍼도 실리콘과 DAF를 일괄, 또는 개별로 다이싱을 할 수 있습니다.
-
실리콘 웨이퍼
칩 상면 사진
-
DAF 점착 실리콘 웨이퍼
칩 측면 사진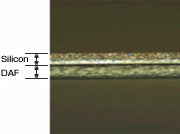
기타 레이저 풀 커팅 가공 예
이면 메탈막 부착 실리콘 웨이퍼, GaP(갈륨인)웨이퍼, InP(인듐인)웨이퍼, GaN(질화갈륨)웨이퍼, Ge(게르마늄)웨이퍼 등.
가공 대응 장비
Low-k 그루빙으로 정평을 받고 있는 Φ300 mm웨이퍼 대응 풀 오토 레이저 쏘 DFL7161의 레이저 헤드와 광학계를 최적화 한 레이저 풀 커팅 다이싱 사양 장치입니다.
문의
질문・상담이 있으시면 언제든 문의해 주십시오.



