The Center Offset Grinding of TAIKO Wafer
Application processing examples
The TAIKO process is a wafer backgrinding method developed by DISCO. This process method leaves a ring (approximately 3 mm) on the wafer outer edge and thin grinds only the inner area of the backside wafer. By leaving this edge ring, it is possible to reduce the risks of wafer breakage or edge chipping.
In this article, we will introduce the center offset grinding as application example of TAIKO grinding.
What is a center offset grinding?
Adjusts grinding position, control center position of wafer and center of grinding position
Advantage of center offset grinding
By applying this grinding method in the TAIKO grinding, an effective area of an OF wafer can be expanded.
Processing example of Center offset grinding
We will introduce the processing example for 6inch wafer (short OF).
(Machine used: DAG810 TAIKO specification)
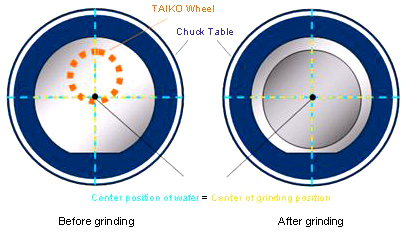

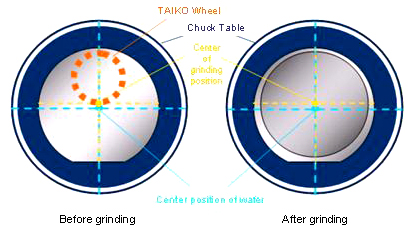
Contact
Please feel free to contact us with any questions or inquiries.
-

Applications Support
A free-of-charge test cut is performed at an application lab to confirm whether achieving the customer's needs is possible.
Details -
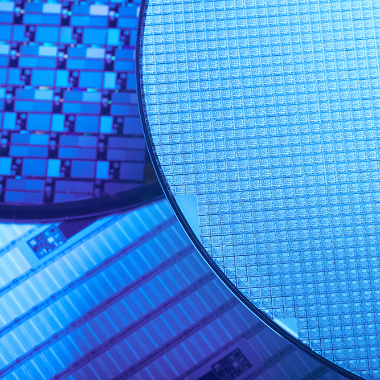
Dicing and Grinding Service
It is effective in sample and prototype manufacturing during development or low-volume production. Designated engineers will provide support based on the desired leadtime and at reasonable cost.
Details
